Electron beam Lithography
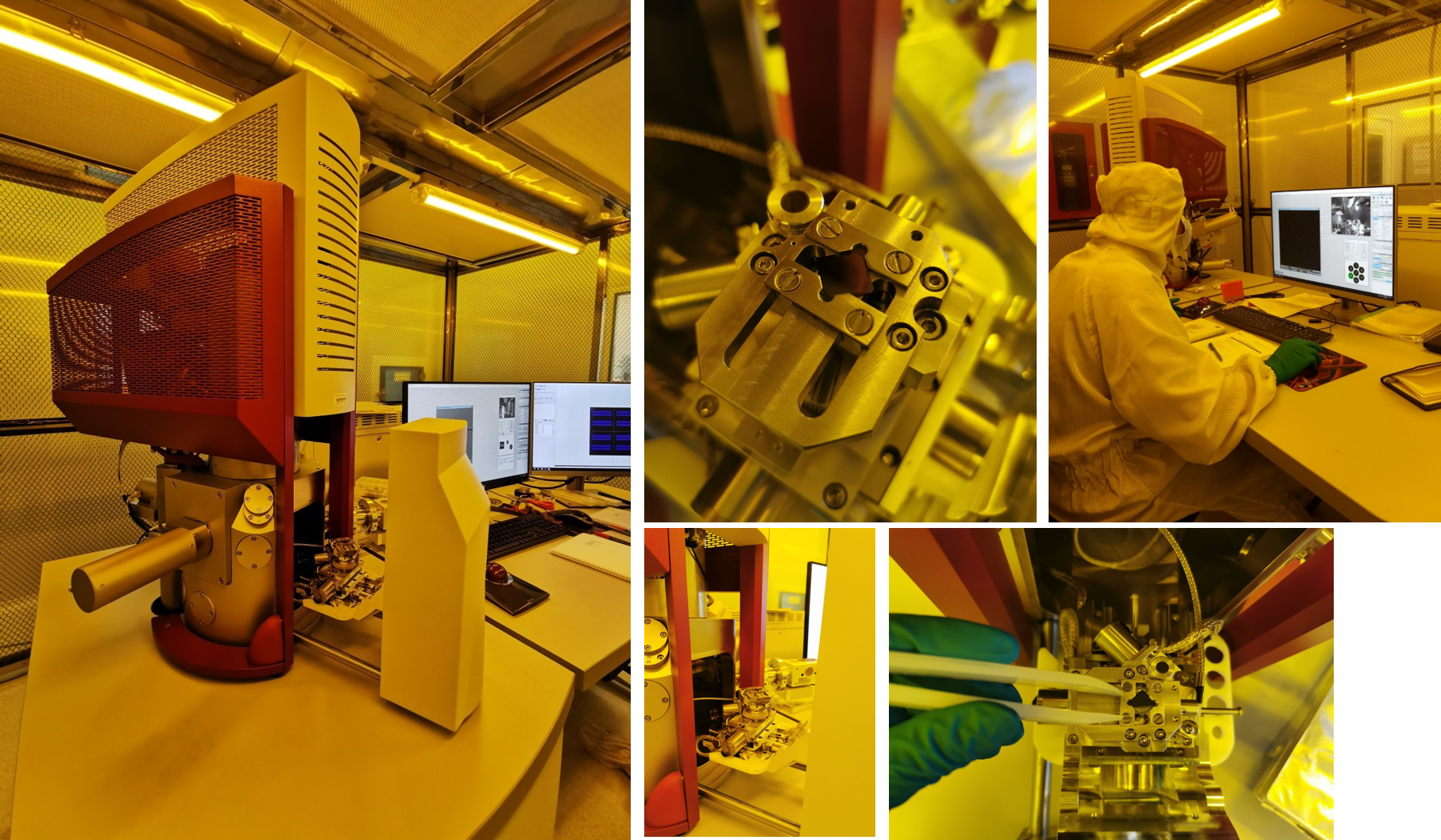
1. กล้องจุลทรรศน์อิเล็กตรอนแบบส่องกราด
กล้องอิเล็กตรอนแบบส่องกราดใช้สำหรับถ่ายภาพวัสดุ หรือชิ้นงานที่มีขนาดเล็กกว่า 1 ไมครอนซึ่งไม่สามารถตรวจสอบโครงสร้างได้ด้วยOptical microscope สำหรับกล้องอิเล็กตรอนแบบส่องกราด TESCAN (MIRA3) สามารถถ่ายภาพได้ที่กำลังขยาย 2 เท่า – 1,000,000 เท่า ระดับพลังงานของลำอิเล็กตรอนสามารถใช้งาน ได้ตั้งแต่ 200 อิเล็กตรอนโวลล์ ถึง 30 กิโลโวลล์ และห้องใส่ตัวอย่าง (Chamber vacuum) ต้องแสดงเลข 9 x 10-3 ปาสคาล หรือสุญญาศที่สูงกว่า
ชนิดของตัวรับสัญญาณ (Detector) มี 2 ชนิด คือ อุปกรณ์ตรวจจับสัญญาณอิเล็กตรอนทุติยภูมิ (Secondary Electron Detector)ให้สัญญาณภาพ 2 มิติเรียกว่า ภาพอิเล็กตรอนทุติยภูมิ(Secondary Electron Image: SEI) สามารถใช้กับงานที่ไม่ได้ผ่านการเตรียมผิวหน้าเรียบมาได้ และอุปกรณ์ตรวจจับสัญญาณอิเล็กตรอนกระเจิงกลับ (Backscattered Electron Detector) ให้ สัญญาณภาพ 2 มิติเรียกว่า ภาพอิเล็กตรอนกระเจิงกลับ (Backscattered Electron Image: BEI) สัญญาณจะถูกตรวจจับด้วยหัววัดหรืออุปกรณ์ตรวจจับสถานะ ของแข็ง (solid state detector) ที่ติดตั้งอยู่ใต้เลนส์ตัวสุดท้ายหรือเลนส์ใกล้วัตถุ (objective lens)
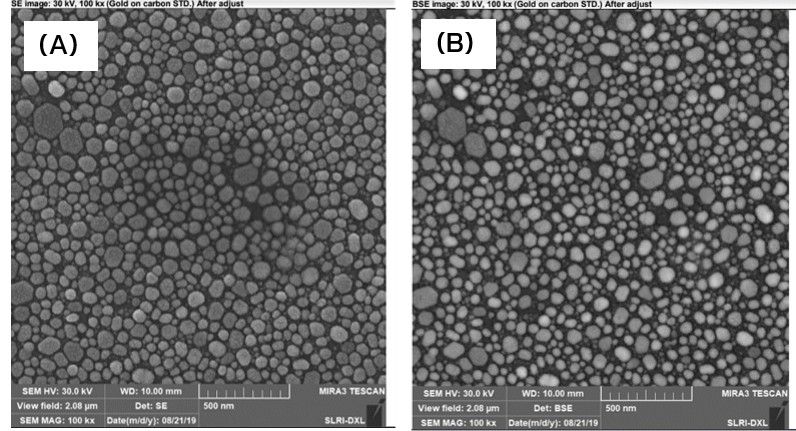
รูปที่ 1 A. แสดงภาพถ่าย FE-SEM จากอุปกรณ์ตรวจจับสัญญาณ ภาพ B. แสดงภาพถ่าย FE-SEM จากอุปกรณ์ตรวจจับสัญญาณอิเล็กตรอนทุติยภูมิ (Secondary Electron Detector) อิเล็กตรอนกระเจิงกลับ (Backscattered Electron Detector)
นอกจากตัวแปรที่ต้องปรับจากเครื่อง FE-SEM แล้วคุณสมบัติการนำไฟฟ้าของวัสดุที่ต้องการถ่ายภาพมีผลต่อการถ่ายภาพอย่างมาก เนื่องจากปกติการวิเคราะห์ด้วยเทคนิค FE-SEM วัสดุที่นำมาวิเคราะห์จะต้องมีคุณสมบัติการนำไฟฟ้า ในกรณีที่วัสดุมีคุณสมบัติการนำไฟฟ้าที่ดี หรือไม่นำไฟฟ้า สามารถเปลี่ยนโหมดการถ่ายภาพให้เหมาะสมกับวัสดุได้ 2 โหมด ดังนี้ 1) โหมดสภาวะสุญญากาศอยู่ในระดับสูง (High vacuum) ประกอบด้วยตัวรับสัญญาณ 4 ตัว ได้แก่ SE detector, I-beam-SE detector, BSE detector, In-Beam-BSE detector 2) โหมดสภาวะสุญญากาศอยู่ในระดับต่ำ (Low vacuum) ประกอบด้วยตัวรับสัญญาณ 2 ตัว ได้แก่ BSE detector, LVSTD ซึ่งโหมดสภาวะสุญญากาศอยู่ในระดับต่ำเหมาะกับชิ้นงานที่ไม่นำไฟฟ้า อย่างไรก็ตามหากต้องการให้ได้ภาพที่คมชัด และถ่ายได้ที่กำลังขยายที่สูงควรนำวัสดุที่ต้องการวิเคราะห์ไปเคลือบด้วยโลหะที่มีคุณสมบัติการนำไฟฟ้า รายละเอียดการใช้ระดับพลังงานของลำอิเล็กตรอนที่เหมาะสมสำหรับการถ่ายภาพดังตารางที่ 1
ตารางที่ 1 แสดงความละเอียดในการถ่ายภาพที่โหมดต่างๆและที่ระดับพลังงานต่างๆ
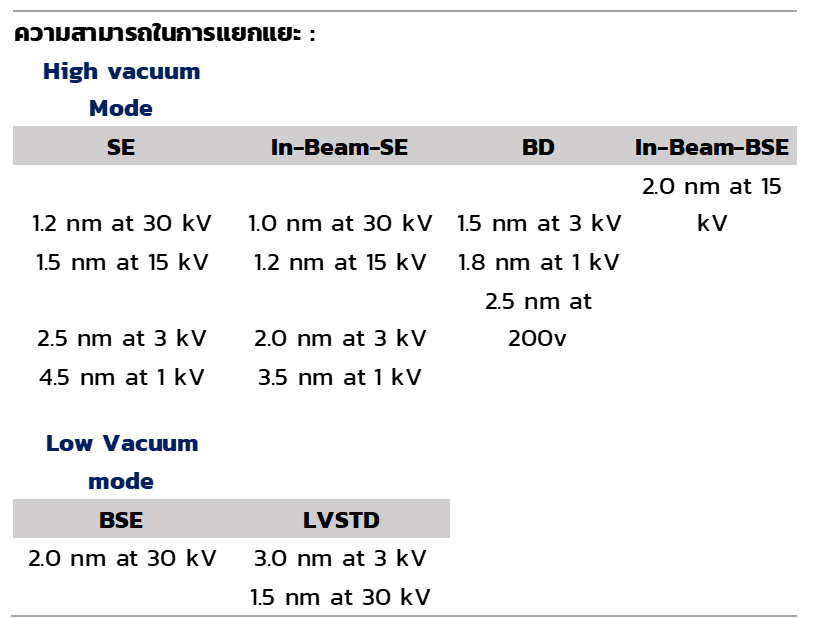
2. กระบวนการสร้างลวดลายระดับนาโนเมตรด้วยลำดฟกัสอิเล็กตรอน (Electron beam Lithography) โดยใช้กล้องจุลทรรศน์อิเล็กตรอนแบบส่องกราด (FE-SEM, TESCAN model MIRA3)
Electron beam Lithography เป็นการใช้ลำโฟกัสของอิเล็กตรอนเพื่อวาดลวดลายในระดับนาโนเมตรลงบนพอลิเมอร์ตัวกลางสำหรับถ่ายทอดลวดลาย หรือเรียกว่า สารไวแสง เมื่อสารไวแสงทำปฏิกิริยากับอิเล็กตรอนและถูกล้างด้วยน้ำยาขึ้นรูป (Developer) จะทำให้เราได้รับโครงสร้างสารไวแสงในระดับนาโนเมตร สำหรับเติมโลหะ เพื่อสร้างโครงสร้างโลหะในระดับนาโนเมตร ซึ่งในปัจจุบันเราสามารถพัฒนาศักยภาพจนสามารถสร้างโครงสร้างโลหะขนาดเล็กในระดับ 100 นาโนเมตร ด้วยกระบวนการ Electron beam lithography ดังรูปที่ 2
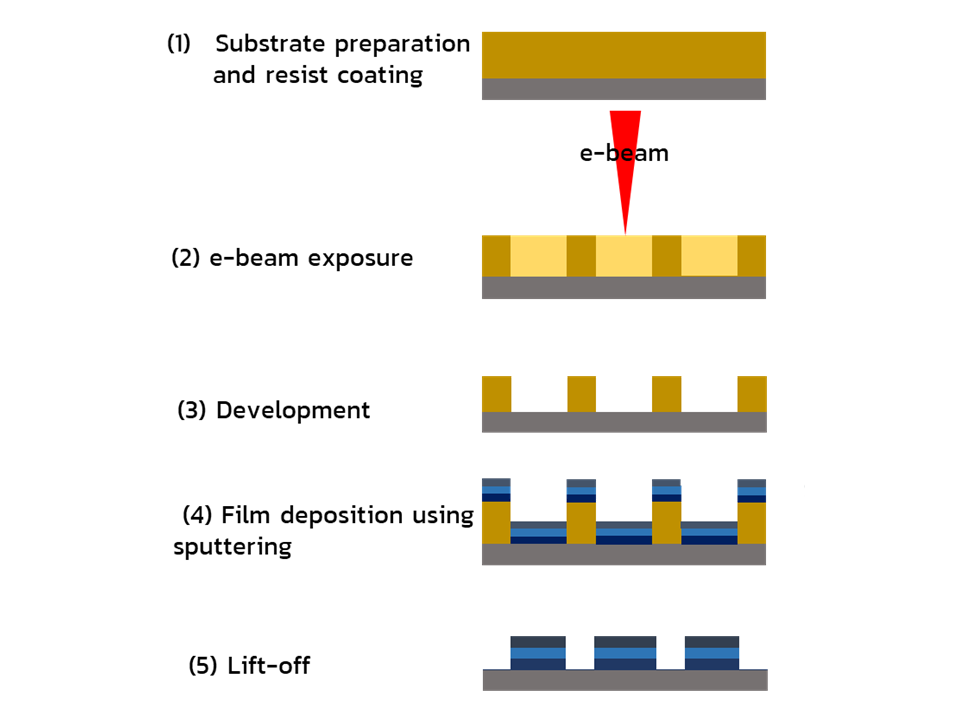
รูปที่ 2 แสดงกระบวนการในการส้รางลวดลายระดับนาโนเมตรด้วยลำโฟกัสอิเล็กตรอน (Electron beam Lithography)